リモートプラズマクリーナーシリーズ
リモートプラズマクリーナー
PIE Scientific社(ピーアイイーサイエンティフィック)
リモートプラズマクリーナーは、分離されたプラズマソースとコントローラで構成され、 ソースはFE-SEM やXPS、EPMA などの試料チャンバーもしくは試料交換室などに接続されます。 接続された試料チャンバーやチャンバー内の試料をプラズマクリーニングすることで、 高真空装置におけるカーボン系コンタミネーションを予防・除去します。
- EM-KLEEN(一般的な高真空チャンバー向け)
- SEMI-KLEEN quartz(半導体インライン装置向け)
- SEMI-KLEEN sapphire(反応性ガス・腐食性ガス対応)
主な特徴
EM-KLEEN、SEMI-KLEEN共通- ターボ分子ポンプ領域で運転可
- 秀逸なユーザーI/Fデザイン
- ハイスピードクリーニング
- 安全重視と高自由度を選べる
2つの操作モード(Safe/Expert) - 選べるコントローラ
(卓上モデル、ラックモデル) - マスフロー制御ガス混合器
(オプション)
- 低粒子汚染(低PWP)
- 低粒子汚染(低PWP)
- 反応性ガス・腐食性ガスに対応
装置概要
リモートプラズマクリーナー『EM-KLEEN』『SEMI-KLEEN 』は、 分離されたプラズマソースとコントローラで構成され、ソースはFE-SEMやXPS、EPMAなどの 試料チャンバーもしくは試料交換室などに接続されます。 接続された試料チャンバーやチャンバー内の試料をプラズマクリーニングすることで、 高真空装置におけるカーボン系コンタミネーションを予防・除去します。
プラズマソース内で生成された活性酸素ラジカルが、 真空装置付随のターボ分子ポンプで試料室内に引かれて拡散します(ダウンストリーム)。 残留したハイドロカーボンガス分子とラジカルが化学的に反応(低温灰化=アッシング)し、 反応による副生成物は真空ポンプで試料室外に排出されることで、 試料室内をクリーニングします。
以下のラインナップがあります。
- EM-KLEEN
- SEMI-KLEEN quartz
- SEMI-KLEEN sapphire
ターボ分子ポンプ領域で運転可
プラズマソースを設置した試料室の真空度が、0.1mTorr~2Torrレンジでプラズマ点火が可能です。 試料室を大気開放する必要が無く、高真空状態から即プラズマクリーニングが可能で、ターボポンプの回転数を下げることなくプロセスを実行します。 ターボポンプを止めないため、クリーニング後わずか数分で既定の真空度に回復します。
※設置する装置や設置箇所(試料室/交換室)、使用目的によって条件は大きく異なります。詳細は別途お問合わせ下さい。
秀逸なユーザーI/Fデザイン
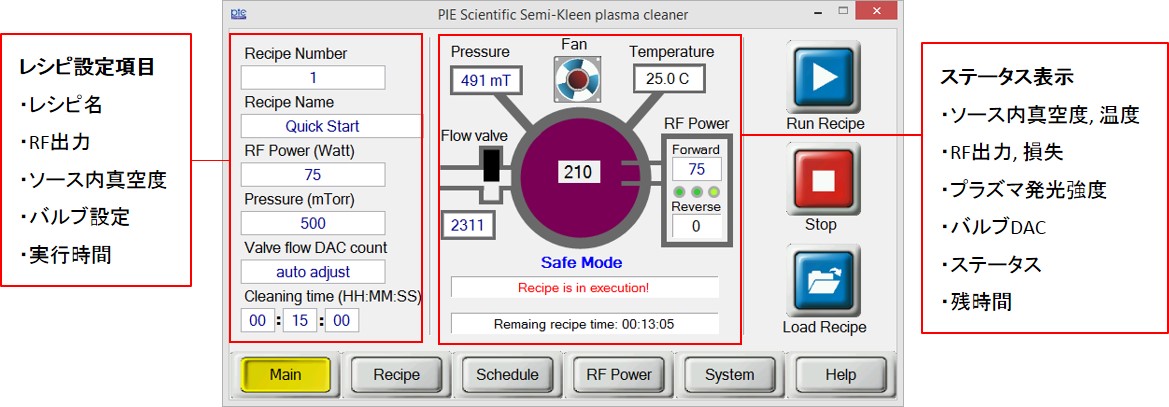
超Highスピードクリーニング
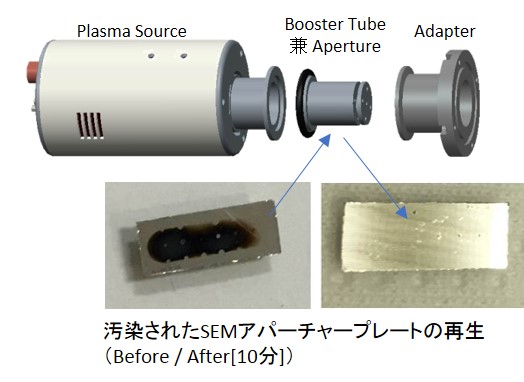
SafeモードとExpertモード
高電圧がかかる検出器を備えたFE-SEMのような分析装置で、ユーザーが装置自体に不慣れな場合、 より安全にクリーニングを実施するためのモードが Safeモード です。 安全に高電圧をoffする手順を知っているユーザーは、融通性のある Expertモード がお勧めです。
選べるコントローラ


ポータブル卓上モデル
19inchラックモデル(オプション)
マスフロー制御ガス混合器(オプション)
Airを導入して行うプラズマクリーニングは、活性酸素による酸化反応によります。
酸化が許容できない場合は、水素プラズマ(原子状水素)による還元反応によりメタン系炭化水素(CHx)に反応させてクリーニングする方法があります。
複数のプロセスガスを混合して実験する場合には、最大3系統のマスフローガス入力ポートと、1系統のVent/Bypassポート、1口の出力ポートを備えたガス混合器が便利です。

- タッチスクリーンI/F
- 3系統のマスフローコントローラ
- タイマー機能
※ 酸素ガス、水素ガスを使用する場合は、プラズマ耐性の真空ポンプを使用して下さい。
※ 酸素ガス、水素ガス等の使用は、ガスの安全マニュアルに沿ってご使用下さい。
製品仕様
| 製品 | EM-KLEEN | SEMI-KLEEN quartz | SEMI-KLEEN sapphire |
|---|---|---|---|
製品画像 |  |  |  |
用途 | SEM、TEM、XPS、SIMS、AES | SEM、TEM、XPS、SIMS、AES、CD-SEM、EB-Litho | ALD、EUV-Litho for NF3、CF4、NH3、H2、HF、H2S プラズマ |
チャンバー | 石英ガラスチューブ | サファイアチューブ | |
プラズマ方式 | ICP(Inductively Coupled Plasma)【誘導結合型】 | ||
RF出力※1 | 0〜75 W | 0~75 W(オプション:0~150 W) | |
動作真空度(ソース内) | 7 mTorr ~ 1 Torr | ||
真空チャンバー真空度 | 0.1 mTorr ~ 1 Torr | ||
真空計 | マイクロピラニゲージ内蔵、大気 ~ 1 e- 4 Torr | ||
インピーダンス整合 | 固定 | 固定 or オート | |
腐食性ガス | 不可 | 可 | |
ソースマウント形状 | NW / KF40(オプション:CF 2.75インチ[CF70]) | ||
PC制御 | RS232 / RS485、Windows.Net Framework 4.0以上 | ||
コントローラ | 可搬型、4 inch タッチパネル、シリアル通信ポート(D-sub9)
| ||
プラズマソースサイズ | φ86×168 mm、1 kg | 140×105×190 mm、2.2 kg | 250×380×130 mm、2 kg |
標準コントローラサイズ | W 305×D 340×H 200 mm、7 kg | ||
150W コントローラサイズ | - | W 220×D 380×H 130 mm、8 kg | |
電源 | AC 90~250 V、50/60 Hz、400 W以下 | ||
※1 RF出力:日本国内では、初期設定でRF出力を49Wまでに制限しています。
“高周波利用設備申請書”の届出により、制限を解除し、75W(オプション:150W)まで使用可能となります。
※2 真空装置の仕様(特にチャンバーサイズやポンプスピード)やソースの設置個所、使用目的や使用方法により大きく異なります。
基本性能
Turbo Discharge™ テクノロジー
高出力ICP(Inductively Coupled Plasma)プラズマ技術により、高効率かつ高真空レンジでのプラズマクリーニングが可能です。
特に高真空領域でのプラズマ効率およびダウンストリームクリーニングにおけるラジカル種の生成スピードを大幅に向上させます。画期的なTurbo DischageTMプラズマソース設計技術は米国特許庁の認可を受けています。
プラズマ発光強度センサー内蔵(プラズマ診断)
安価なプラズマ装置にはプラズマ診断機能が無く、
オペレーターがプラズマ強度を視認するしかありませんが、
人の目はダイナミックレンジを自動で調整するため、定量的な診断は出来ません。
内蔵センサーは、定量的にプラズマ発光強度を診断することで、
より詳細にレシピを最適化することが可能で、
一貫したクリーニング結果を得ることが出来ます。
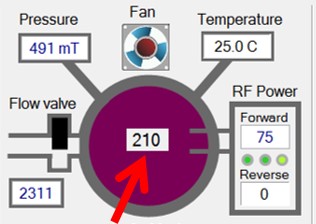
真空ゲージ内蔵
MEMS加工技術による小型熱伝対真空系を内蔵。
1e-4Torr ~ 760Torrまで測定可能。
内部温度センサと冷却ファン
プラズマクリーニング中はプラズマソース内が発熱しますが、 真空環境のため通常はクーリングができず、オーバーヒートすることがあります。 リモートプラズマクリーナーは内部に温度センサと冷却ファンを持ち、プラズマソースが60度を超えない様に監視・制御を行います。
外部電極構造により微量金属汚染を低減
内部電極のプラズマシステムでは金属電極にRFが印加され、この場合、電場が電極端で強くなるエッジ効果により、一様性を得ることは難しく、また内部電極がスパッタリングされることで、試料の金属汚染が問題になります。
本製品では、電極を石英ガラスチューブの外部に配置することで、試料の金属汚染を極めて低減します。
タッチパネルスクリーンと直観的なI/F
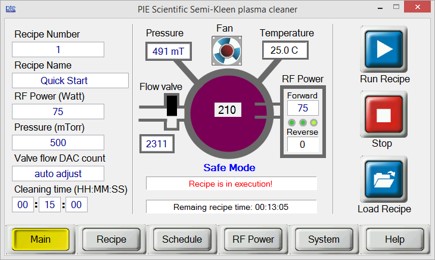
レシピ登録・管理

RF出力 0~75W可変 @13.56Mz
日本国内では、初期設定でRF出力を49Wまでに制限しています。 “高周波利用設備申請書”の届出により、制限を解除し、 75Wまで使用可能となります。
オート制御
独自のプラズマ点火アルゴリズムにより、レシピを選択・実行するだけで、自動でクリ―ニングプロセスを実行します。
自動インピーダンスマッチング機能(EM-KLEENを除く)
効率良くプラズマを発生させるためには、 RF電源とプラズマソース間のインピーダンスマッチング(整合)が必要ですが、 手動によるインピーダンスマッチングは慣れが必要で面倒な作業です。 自動マッチング機能は、確実で素早い自動整合を行い、 安定したプラズマを発生します。
オートガス流量制御
熱式流量計と電子流量制御弁によるマスフローコントロール。
応答速度 0~50sccm
コンタミネーションの発生原理と弊害
なぜコンタミネーションが発生するのか?
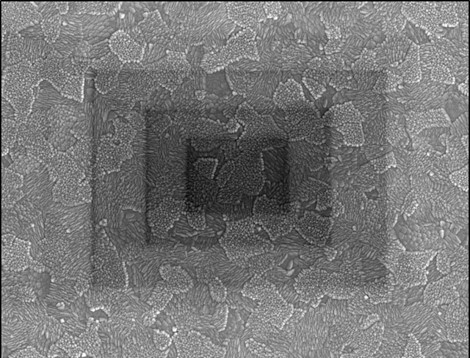
試料表面に堆積したコンタミネーション
試料から二次電子(<50eV)が発生
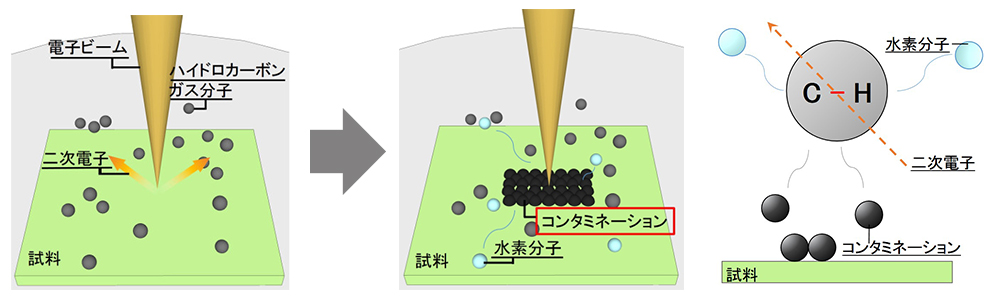
▼もっと詳しく(クリックで展開)
ステージやバルブに用いる潤滑材、真空グリス、ポンプ油、大気、
更には試料そのもの(特に蒸気圧の高いポリマーやレジストなど)、
これらはあらゆる高真空装置において炭化水素汚染の原因である
ハイドロカーボンのソースとなります。
分子量の大きい汚染物質は試料表面や真空チャンバー壁に付着し、
これらをガスパージで取除くことはできず、高分子材料が真空中に曝されると、
含有されている低分子有機物がガス化し真空中に放出されます。
試料室内は高真空に保たれていても、試料室内に残留した汚染物質や試料そのものから
アウトガスが放出されるため、試料表面は炭化水素系のガス分子に覆われた状態となります。
電子線やEUV、X線などの高エネルギー光ビームは、こうした残留ガス分子
(ハイドロカーボン汚染物質)を分解し、それによる副産物(主にカーボン)は
ビーム照射された試料表面や光学系などの表面で重合し、
汚染物質として試料表面に堆積されます。
コンタミネーションによる弊害
- 像コントラストや分解能の低下(特に極表面観察時の低加速電圧や、コントラストが得づらい平坦な試料において顕著)
- コンタミ付着による試料最表面の形態変化、偽信号の生成
- EDX、EELS等の元素分析や、EBSDのような表面敏感な分析の弊害
- 検出器の検出効率・感度の低下
- アパーチャー汚染によるビーム電流の変動・光学系分解能の低下
- 鏡筒内汚染によるビームドリフト・フォーカス変動・収差
- 光学系(X線・EUVミラー, 回折格子,FZPなど)の反射率や透過率の低下
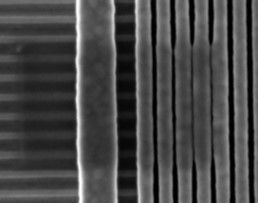
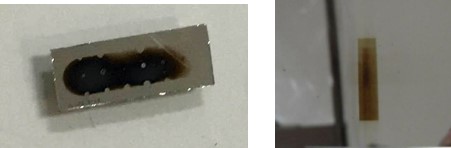
ダウンストリーム式プラズマクリーニング原理
※以下ではEM-KLEEN(リモートタイプ)をベースにしますが、Tergeo(卓上タイプ)も同様です。 ただし、TergeoのImmersionモードは除きます。

ラジカル種(O, O3, OH, H)を生成
拡散(ダウンストリーム)
反応(アッシング)し、水分子などとなって
真空ポンプでチャンバー外に排出
▼もっと詳しく(クリックで展開)
クリーニング対象の真空チャンバー、もしくはクリーニング対象物(試料や汚染コンポーネントなど)
をセットした真空チャンバーにプラズマソースを接続し、ソース内部の石英チューブはチャンバーと一緒に真空引きされます。
コントローラ(高周波電源)からプラズマソースにRF信号が伝達されると同時に、
ソースの通気バルブを介してプロセスガス※1 を導入し、チューブ内にプラズマを発生させて活性ラジカルを生成します。
チューブ内のラジカルは真空装置付随のポンプでチャンバー内に引かれて拡散します。
チューブ内(上流)からチャンバー(下流)へのラジカルの流れをダウンストリームと呼びます。
チャンバー内で拡散されたラジカルは、チャンバー内に残留した ハイドロカーボンガス分子や、クリーニング対象物やチャンバー壁に 堆積した有機物と化学的に反応(低温灰化, アッシング)して低分子化され、 最終的には二酸化炭素や水分子などの副生成物となって真空ポンプでチャンバー外 に排出されることで、チャンバーおよび対象物をクリーニングします。
※1:通常はAirまたは酸素ガスをプロセスガスとして導入する
ことで酸素ラジカル(原子状酸素)を生成し、酸化反応により
クリーニングを行います。酸化が許容できない場合は、ガス種に水素を用いた
水素プラズマ(原子状水素)による還元反応で
クリーニングする場合もあります。
主な使用方法
予防的な使い方 アンチコンタミネーション:コンタミを堆積させない
汚れを真空試料室に持ち込まない
Case1
卓上型プラズマクリーナで試料ホルダをPreクリーニング
試料やホルダの表面にはコンタミネーションの原因となるハイドロカーボンが付着しています。 真空試料室に試料やホルダを入れる直前にPreクリーニングすることで、 試料室内へのハイドロカーボンの持込みを防ぎます。
適応機種:Tergeoシリーズ

Case2
試料交換室で試料やホルダをPreクリーニング
装置にプラズマソースを設置できる試料交換室がある場合、 交換室内で試料やホルダのPreクリーニングを行うことで、 試料室内へのハイドロカーボンの持込みを防ぎます。
適応機種:EM-KLEEN, SEMI-KLEEN
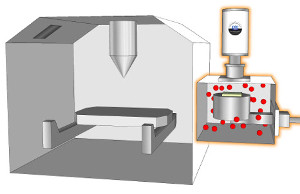
Case3
試料室内でPreクリーニング、同時に試料室内のクリーニング
装置に試料交換室が無い場合は、
試料室に設置したプラズマソースを用いて、
試料室内で試料やホルダのPreクリーニングを行います。
この時間で同時に試料室内のクリーニングにも効果があります。
適応機種:EM-KLEEN, SEMI-KLEEN
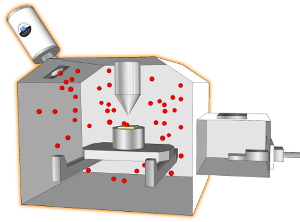
真空試料室内の定期コンディショニング
汚染の原因となる炭化水素は至るところに存在し、 様々な経路で試料室内に侵入します。対象サンプルそのものが 汚染源である場合もあり、試料室内は徐々に汚染されます。 定期的に試料室をクリーニングすることで、試料室内に残留した 炭化水素を分解除去し、試料室内を清浄な状態に保ちます。
適応機種:EM-KLEEN, SEMI-KLEEN
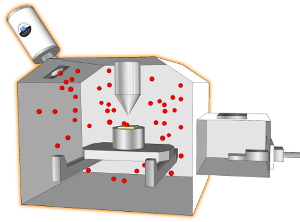
除去的な使い方 クリーニング:堆積したコンタミを取り除く
汚染された試料やコンポーネントのPostクリーニング
電子ビーム照射により付着したコンタミを除去クリーニング
例:
- 分析などで長時間露光により試料表面に堆積した
コンタミネーションの除去 - アパーチャーや検出器の再生クリーニング
適応機種:Tergeoシリーズ, EM-KLEEN(試料交換室)

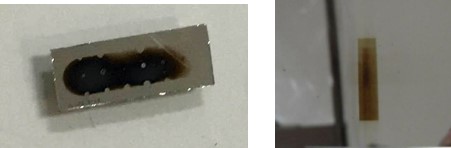
ラインナップ
ベーシックモデル
特殊仕様
プラズマクリーナーについてよくあるご質問
Q.リモートプラズマクリーナーが低圧で使用できるメリットは何ですか?
主に3つのメリットがございます。
- 高真空(0.1mTorr~2Torr※)でプラズマ点火が可能ですので、ターボポンプを停止する必要がありません。
ユーザーはガンゲートバルブを開き、チャンバーに接続されている他の高電圧装置の電源を切るだけで使用できます。 - チャンバー内壁の圧力が 20mTorr より高い場合、新たに生成されたラジカル種はプラズマソースから拡散する前に相互に再結合してしまいます。低圧状態は、チャンバー内のラジカル種の損失を低減します。
- プラズマソースを低圧で作動させることで、発生源とチャンバーとの間のコンダクタンスを非常に大きくすることができます。それにより、新たに生成したラジカルが洗浄チャンバー内に容易に拡散できるようになります。
※ 設器条件によって異なります。詳細は担当営業にお問い合わせください。
Q.自動RFインピーダンスマッチング(整合)のメリットは何ですか?
プラズマソースが常に最適なRF条件で動作するので、手動によるインピーダンスマッチングを行う必要がありません。
多くのRFプラズマシステムでは、単に反射RF電力をゼロにすることは、必ずしもプラズマソース内部のRF結合を最適化を意味するものではありませんが、 PIE社の自動インピーダンスマッチングアルゴリズムは、内蔵のプラズマプローブにより、反射電力を最小にすることに加えて、プラズマ強度を最適化することが可能です。
Q.最適なレシピはどのように設定すれば良いのですか?
センサーからフィードバックされたプラズマ強度に基づいて、ソース真空度(もしくはガス流量)およびRF電力を調整できます。
異なる真空システムは、異なるポンプ速度および異なるチャンバサイズを有します。したがって、最適なガス流量は、システムによって異なる場合があります。
PIE社のプラズマクリーナーは、ガスの流れを電子的に制御することができます。ユーザーがソース内の真空度を変更すると、流量コントローラは設定された圧力を維持するようにガス流量を自動的に調整します。
プラズマ強度は内蔵されたプラズマセンサーにより監視できます。
ユーザーは表示されるプラズマ強度を元に、所望のクリーニング速度に対するソース真空度、RF電力を調整することで最適なレシピを作成できます。


